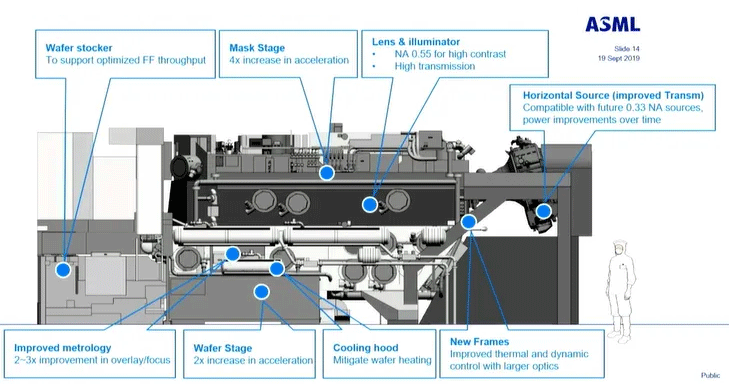
約3億ドル相当の高開口数0.55(高NA EUV)の将来のASMLスキャナー 出典:ASMLプレゼンテーション
オランダの会社ASMLは、深紫外(EUV)でのフォトリソグラフィ装置の独占企業であり、数年先の技術的リーダーシップのマージンを持っています競合他社の ... したがって、次世代スキャナーの遅延は会社の利益に影響を与えないと、 情報筋はアルファを求めていると言います。それどころか、ASML は現在の世代の機器を販売することでさらに収益を上げます。
一部の専門家は、現在の状況ではアップグレードの時間がまったくないと考えています。赤字が非常に大きいため、反対に、一部のメーカーは以前の超小型回路の生産を再開して います。 以前に廃止された世代。
しかし、これは市場の状況です。もちろん、TSMCとSamsungは将来的に技術プロセスを改善する予定です。唯一の問題は、マルチパターニングへのアップグレード (ノードを 5/3 nm に減らして、いくつかのフォトマスクを介したリソグラフィとエッチングの数回の連続操作) を使用して、現在の装置で次のプロジェクトを実装することでした。 3/2 nm で 1 つのテンプレート。
現在の深紫外リソグラフィの装置は ASML NXE: 3400C であり、次世代の高 NA EUV リソグラフィ スキャナーは ASML EXE: 5000 になります。まったく新しい NA 0.55 の光学系が装備され、シリコン ウエハー上のエッチング要素のサイズが大幅に縮小されます。

開口数と解像度の計算方法は、スキャナーの 2 つの主要な特性です。出典: ASML プレゼンテーション

レーザー (右下) から照明装置への光パルス経路、実際の ASML スキャナーでのシリコンウエハーへの投影光学系による結晶トポロジーを備えたマスク
.新しい機器への移行は 2025 年または 2026 年に延期されます。これらのシステムは、生産において複雑すぎて高価であることが判明した、と 書いています。アルファを求めています。 2 階建てバスと同じ 180 トンの車両は、それ自体がエレクトロニクス業界の複雑な物流の証です。コンポーネントは、約 5,000 のサプライヤーによって製造されています。たとえば、ドイツのカールツァイスはレンズを製造しています。オランダの VDL - プレートを機械に供給するロボット マニピュレータ。光源は、2013 年に ASML に買収されたアメリカの企業 Cymer によって製造されています。
報告によると、高NA EUVスキャナー1台の費用は約3億ドルです(現在の世代のASMLスキャナーはそれぞれ約1億8000万ドル)。おそらく、それは世界経済で最も高価な産業機器になるでしょう。
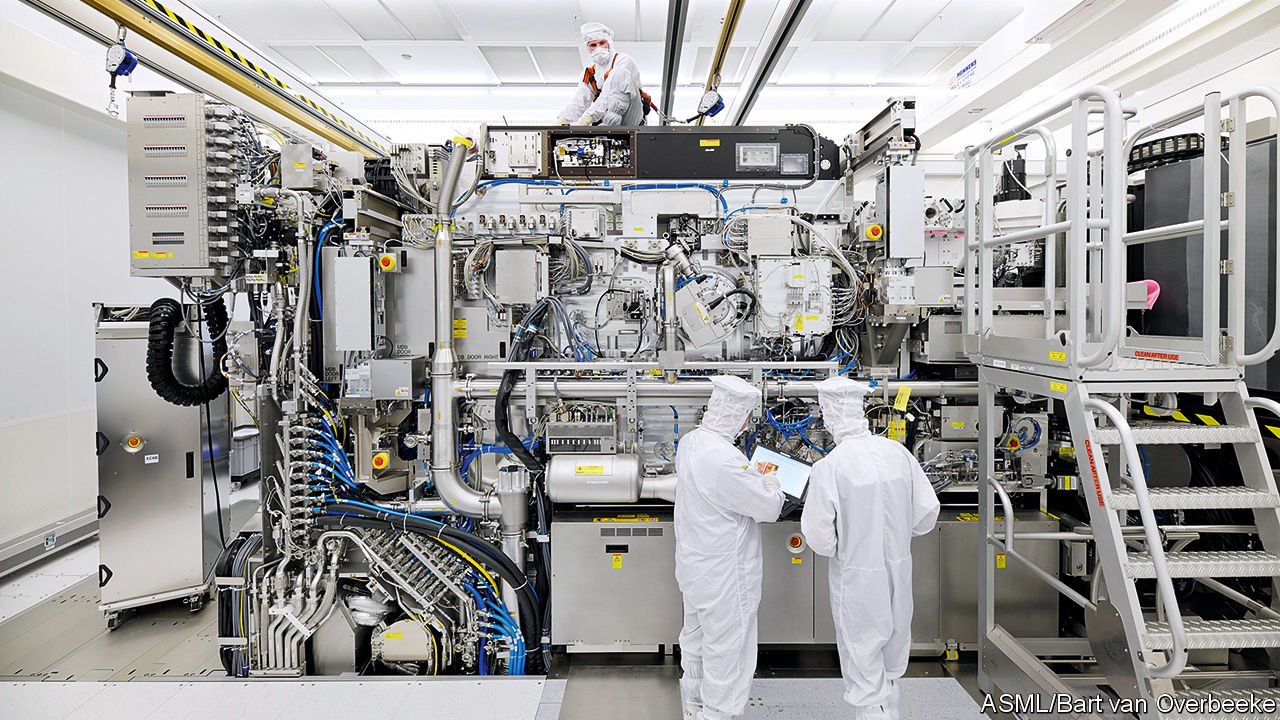
ASML EXE: 5000 スキャナーのレイテンシーにはまったく問題はありません。3 nm のマイクロ回路は新しい装置で作成できますが、おそらく、古いスキャナーでいくつかのパスで他のアーキテクチャを使用して作成されます。そして、次世代スキャナーは 2nm チップを使用します。
7 nm および 5 nm チップ用の現在の EUV 装置は、0.33 NA の光学系と 1 ~ 2 回のリソグラフィー露光を使用します。ある時点では、ダブルパスは簡単に思えました。現在、EUV デュアル パターンは多くのデバイスにとって複雑で高価すぎるという懸念が高まっています。3 nm では、トリプル パスが必要になる場合がありますが、これはさらに困難です。
深紫外フォトリソグラフィー
長年にわたり、チップ メーカーはノード サイズを 1 世代あたり 30% ずつ体系的に縮小し、それによって各トランジスタのコストを削減してきました。これにより、より強力なプロセッサを製造することが可能になりました。このサイクルは、約 18 か月ごとに着実に進んでいます。
フラット トランジスタが壁にぶつかる 20nm マークまでは、製造は簡単でした。 2011 年以降、チップ メーカーは 22nm および 16/14nm の縦型ゲート トランジスタ (FinFET) に切り替えました。
FinFET は高速で消費電力が少なくて済みますが、製造が難しく高価です。したがって、新しいノードへの移行時間は 18 か月から 2.5 年に増加しました。
リトグラフも困難に直面した。リソグラフィプロセスは、フォトマスクから始まります。
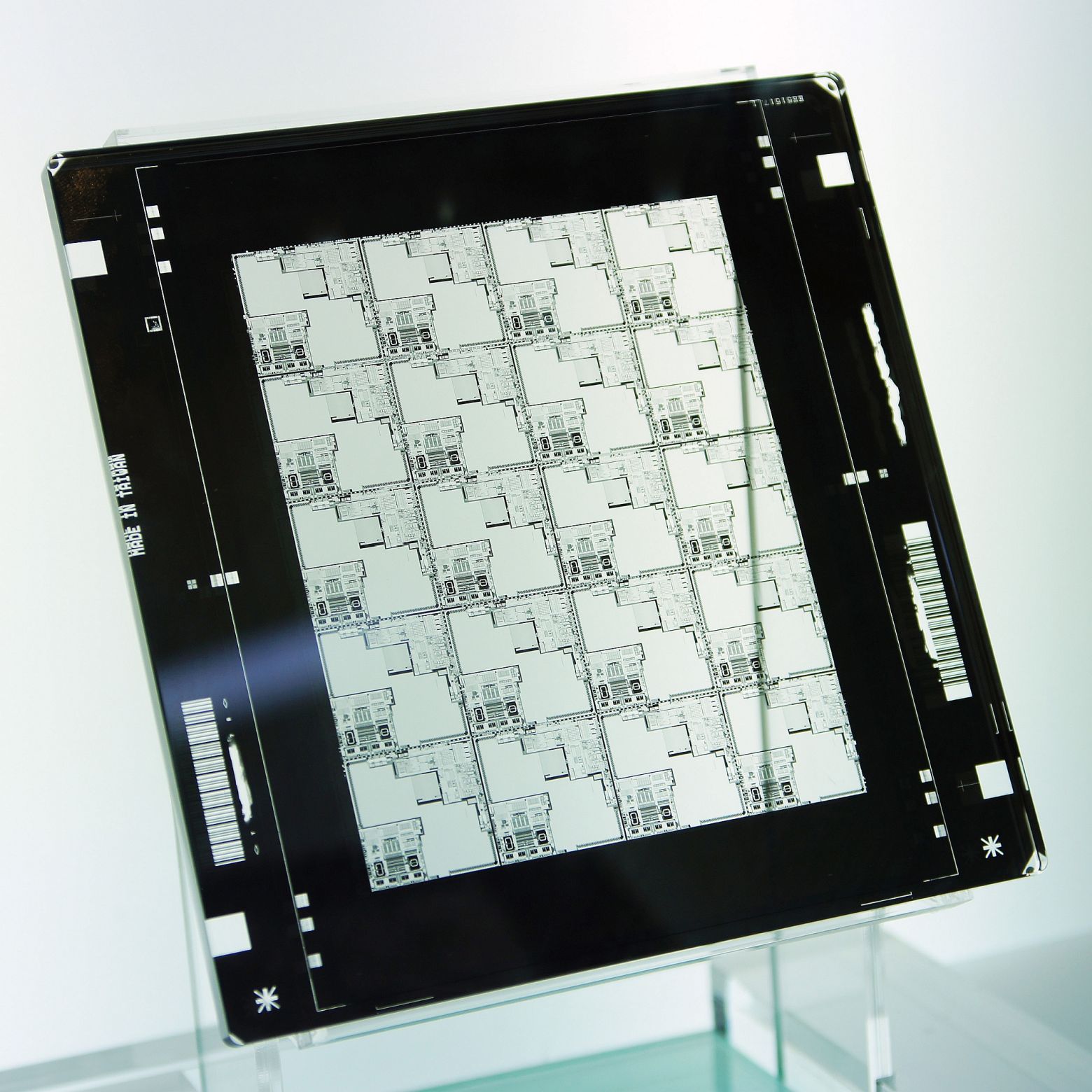
フォトマスク
工場では、フォトマスクをスキャナーにセットします。彼はマスクを通してプレートに光を投影し、その上にパターンを作成し、酸でエッチングして取り除きます。これは 28 nm のステップ サイズの単純なプロセスですが、すでに 20 nm からはパーツが密集しすぎて、ウェーハ上に個々の要素を印刷することが困難になります。

光学的近接効果補正を備えたリアルなフォトマスク。著者: LithoGuy
したがって、チップ メーカーは、元のデザインを 2 つ以上の「スパース」フォトマスクに分割するマルチパターニングに切り替えました。これらの要素をウェーハに適用するために、チップ メーカーは、自己整合スペーサーやダブル パターニングなど、工場でさまざまなプロセス デザインを使用します。
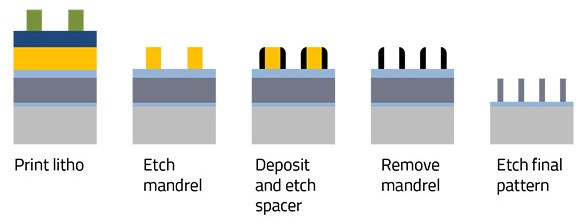
自動調整スペーサーは、マスクのずれを防ぎます。出典: Lam Research

二重架橋により密度が増加します。出典: Lam Research
最先端の ASML スキャナー NXE: 3400C は、13.5 nm の波長と 0.33 NA の光学システムを使用しています。246 ワットの電源装置は、170 枚のウエハー/時 (WPH) スループットを提供します。
Samsung、TSMC、Intel は、ASML NXE: 3400C スキャナーを使用して、7 nm および 5 nm テクノロジー ノードに徐々に移行しています。入手可能な情報によると、 7 nm プロセス技術では、40 nm ステップの 1 パスで十分ですが、すでに 5 nm チップでは、同じ TSMC が 30 nm ステップを使用しており、この開口部の物理的限界に近いです。 .
高NAとは?
5 nm または 3 nm でも二重架橋は可能ですが、これが垂直ゲート半導体の限界です。次に、ナノシート トランジスタ(ナノシート FET)をマスターする必要があります 。


ナノシートトランジスタ
フォトマスク上での画像解像度を上げることができる高開口数(高NA)の新しいASMLスキャナーは不可欠です。
ASML は 1 月の報告会議で、EUV の新しいバージョンの実装を少なくとも 3 年間遅らせると発表しました。以前は、2023 年までに技術を習得する予定でしたが、現在、計画は 2025 年または 2026 年に延期されています。 専門家に
よる と、高NAプロセス技術を習得するには、多くの技術改善が必要です。業界はそれらに取り組んでいますが、ここにはいくつかの未知の要素があります。
近年、チップ メーカーは他のチップ パッケージ アーキテクチャ(2.5D、3D-IC など) と並行して作業を 行い、NA のレイテンシが高い場合でもチップをさらにスケーリングしています。
ところで、現在の高NAの遅延は、業界が長い間193nm液浸リソグラフィに固執し、最終的に装置の売上を押し上げたことを思い起こさせ ます。したがって、ASML ビジネスの観点からは、まったく問題はありません。会社は、第 1 世代の EUV でより多くの利益を得るでしょう。それはまた、長い遅れで市場に参入しましたが、ひどいことは何も起こりませんでした。
ASML NXE:3400Cスキャナーの導入は2020年に始まりました。TSMC、Samsung、Intel の上位 3 メーカーのうち、最初の 2 社は深紫外フォトリソグラフィ用の最新の ASML 装置の使用をリードしており、Intel は 2022 年末にのみ EUV リソグラフィに切り替える予定です。